最近,國產SiC設備又傳來振奮人心的消息——北京中電科電子裝備有限公司的SiC晶錠和晶片減薄機實現了6/8英寸大尺寸和新工藝路線匹配的雙技術突破。
據了解,該技術已經在SiC襯底制備段及器件背面減薄段實現了小批量應用,并且獲得了頭部企業的一致認可,而且新的減薄機協同SiC激光改質剝離切割技術,可以大幅降低SiC襯底成本和工時。
眾所周知,SiC襯底制備挑戰極大,尤其是切磨拋關鍵環節。傳統的砂漿線等切割及研磨技術發展較為成熟,但存在加工效率低、材料損耗大、自動化程度低、面型一致性差等問題,從而導致SiC襯底難以降低成本,阻礙了SiC器件的廣泛采用。
砂漿線切割技術不足
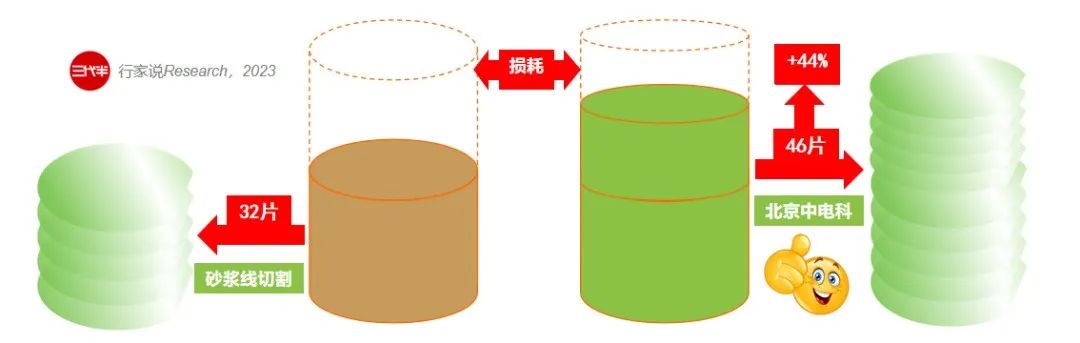
加工時間對比
SiC襯底切磨拋環節路線對比
WG-1250碳化硅自動減薄機和WG-1261碳化硅全自動減薄機
最近,北京中電科公司自研的6/8英寸WG-1250碳化硅(晶錠)自動減薄機、WG-1261碳化硅(晶片)全自動減薄機核心技術指標均取得了關鍵性突破,6/8英寸SiC減薄后厚度均勻性TTV≤2μm(晶片)/TTV≤3μm(晶錠);翹曲度(WARP)≤30μm(晶片);表面彎曲程度(BOW)≤±15μm(晶片);UPH≥4片/小時(激光剝離面@單面去除80μm),UPH≥7片/小時(多線切割面@雙面去除各70μm),這些技術指標的突破與設備產品的推出,標志著北京中電科公司駛入SiC襯底、SiC器件產業鏈發展的快車道。
SiC晶片/晶錠減薄前后及實驗數據
據了解,該公司是在原有6英寸SiC自動減薄機和12英寸Si晶圓全自動減薄機的基礎上,進一步優化大功率低振動氣浮主軸和高剛度高精度氣浮載臺設計,突破晶圓厚度分區域自動控制技術、晶錠厚度(≤5cm)自動測量技術、不同厚度晶錠同臺同時加工技術及磨削/進給自動快速迭代技術等,不斷優化激光改質剝離切割后的晶錠/晶片磨削工藝。
此外,北京中電科還聯合鄭州三磨所進行粗、細、精等金剛石磨輪耗材的工藝適配,克服了SiC材料磨不動不好磨、晶圓面型控制精度差、磨輪損耗大與匹配性差等問題,滿足了6/8英寸雙尺寸、高質量的減薄需求,受到頭部企業的一致認可。
自主可控的SiC減薄用關鍵核心零部件
北京中電科公司表示,他們這次推出的WG-1250碳化硅(晶錠)自動減薄機、WG-1261碳化硅(晶片)全自動減薄機,可聯合國產激光改質剝離切割、晶亦精微SiC專用CMP、太原風華SiC缺陷檢測等設備,助力國產6英寸SiC襯底制造的核心裝備局部成線能力快速躍升。他們始終以更快、更準、更精為導向,從更精尖技術、更優越性能和更穩定工藝等多維度持續優化SiC減薄設備,助力我國SiC襯底快速邁進8英寸時代。
插播:了解全球碳化硅/氮化鎵產業趨勢、項目等,可掃描下方二維碼
本文鏈接:http://www.www897cc.com/showinfo-27-9668-0.html國產SiC技術再突破,獲頭部企業一致肯定 聲明:本網頁內容旨在傳播知識,若有侵權等問題請及時與本網聯系,我們將在第一時間刪除處理。郵件:2376512515@qq.com 上一篇: 達成戰略合作!這家GaN要建IDM項目